



2次元エリプソメータ
BEPEとMFE アルゴリズムは多層膜のデータを大量に一度に測定することができます。 BEPEは与えられたサンプルの構造のモデルにしたがって膜厚と屈折率を測定するだけでなく、 サンプルの構造を探求する手段でもあります。これまで“VOID”というあいまいな言葉で呼ばれていた内部構造の実体を解析することができます.以下のレポートで報告するのはBEPE−QR120Kを使ってポリシリコンの光学特性を観測したデータです。
厚い酸化膜の上に堆積されたポリシリコンフィルムは容易に測定することができます。(Fig.1) しかし、シリコンとポリシリコンの屈折率はほとんど同じなので、シリコン上に直接堆積したポリシリコンの 光学的測定を確実に行うことがこれまではできませんでした。BEPEは屈折率を極めて正確に測ることができるので、 シリコン上のポリシリコンの光学的特性を測定することができます。
そしてその測定結果からMFEアルゴリズムによってポリシリコンとシリコンとの界面構造を解析することができました。
測定に使用したウエハーサイズは150mmで、ウエハーの前面は鏡面研磨され、裏面はエッチング処理されています。 実験的にシリコンウエハーの両面にポリシリコンを堆積して測定してみました。そのとき、基板に堆積されていた自然酸化膜の除去処理は行っていません. ポリシリコンの膜厚がそれぞれ異なるおのおの6枚づつ3種類のサンプルについて測定しました。ポリシリコンの膜厚が違っても本質的にほぼ同じ結果であったので、 以下では膜厚1.2μmのサンプルについて報告します。
Fig.1 Polysilicon film on the thick oxide layer
(Polysilicon 1.2μm/SiO2 0.3μm/Si) |
 |
 |
 |
ポリシリコンが1層膜であるとして解析するとリズナブルな答えをえることができませんでした。 つぎにポリシリコンが2層膜であると考えて測定してみると、膜厚と屈折率の値は全体としてかなり満足できる値になりました。 しかし基板に近い層の屈折率は奇妙な値をしていました。
エリプソメトリーにおいては解が求まらないこともまた重要な情報なのです。そのことはサンプルの実際の構造が, 最初に想定していたモデルより複雑な構造をしていることを示唆しています。
屈折率は膜の密度と誘電率に関係しています。したがって、屈折率の変化を厚み方向に調べることによって、膜の厚み方向での構造遷移または組成遷移の推定を行うことができます。
MFEアルゴリズムと測定精度
エリプソメータで測定する膜厚の値は境界と境界との距離であって、AFMのようにサンプルの外部にある座標系に関する表面 の凹凸を測定するのではありません。この膜のように屈折率が連続的に変化している場合、明確な反射境界を持つ膜とは違って、 層、層の数、境界という言葉には不明確さが残ります。この場合、MFEアルゴリズムはインプットされた膜の層数にもとづいて層の 境界を最適化するように探索し、境界と境界との間の実効的な屈折率と膜厚を計算します。
MFE algorithm: Multilayer thin Film Ellipsometry algorithm 多層膜の膜厚と特定波長での屈折率を同時に測定解析できるアルゴリズム。U.S. Patent allowed.
最終的に、ポリシリコンは表面から見て Top,Up, Middle, Down /Substrateの4層からなっているとして解析してみました。
Fig.2Structure of Polysilicon on Mirror Polished Silicon Substrate
| Refractive Index | Thickness |
|---|---|
 |  |
| Top Layer | |
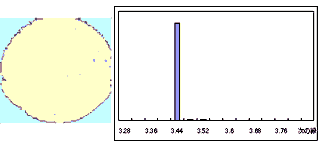 |  |
| Up Layer | |
 |  |
| Middle Layer | |
 |  |
| Down Layer |
Fig.3 Structure of Polysilicon on Etched Silicon Substrate
| Refractive Index | Thickness |
|---|---|
 |  |
| Top Layer | |
 |  |
| Up Layer | |
 |  |
| Middle Layer | |
 | 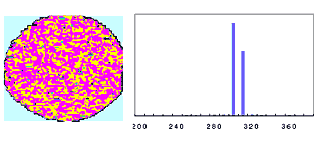 |
| Down Layer |
Middle LayerとDown Layerの膜厚の位相関係を調べてみると興味深い結果が出てきます。Middle Layerと Down Layerを合成した層をInterfacial Layerと呼ぶことにします。Fig.4はInterfacial Layerの膜厚分布です。
裏面につけた膜のInterfacial Layerは前面(鏡面側)につけた膜のInterfacial Layerよりもかなりランダムで、 膜厚も幅広く分布しています。Interfacial Layerの膜厚分布の分散はシリコン基板の平坦性、またはマイクロラフネスの低周波成分によって説明されるでしょう。 Interfacial Layerのうち、基板に近いDown Layerはまだ基板のラフネスの影響を受けていてMiddle Layerになってその表面はほぼ フラットになっていると解釈することができます。
このようにしてPolysiliconとSiliconとの界面の構造がどのようにシリコン基板表面の粗さに影響されるのかを観察することができました。 またシリコン基板表面のラフネスをInterfacial Layerの膜厚の分散として捉えることができました。
このようにMFEアルゴリズムによって膜の構造のリアリティーが次第に明らかになってきました。
Fig.4 Thickness of Interfacial Layer
| Front Surface | Back Surface |
|---|---|
 |
 |
Fig.5 Analyzed model of Polysilicon film
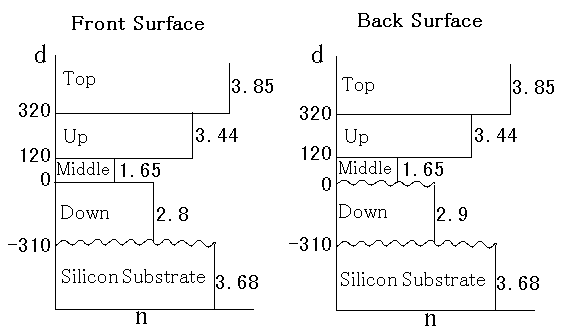
私たちはこのサンプルのモデルとして Fig.5のような構造を設定することができます。
このような光学的構造の原因は何でしょうか
結晶粒の粒径が厚み方向に変化しているのでしょうか?
それはまたプロセスパラメーターとどのように関係しているのでしょうか? またデバイスの特性にどのように影響していくのでしょうか?
HEUREKAのBEPEシリーズとMFEアルゴリズムを使うことによって、探求すべき新しいテーマを見つけることができます。